주사전자현미경(SEM)
SEM(Scanning Electron Microscope)
| 모델명/제조사 | S-4700 / Hitachi |
|---|---|
| 위 치 | 푸른솔문화관 111호 |
| 예약문의 | 02-961-0215 |
연구중심 대학
경희대학교 중앙기기센터
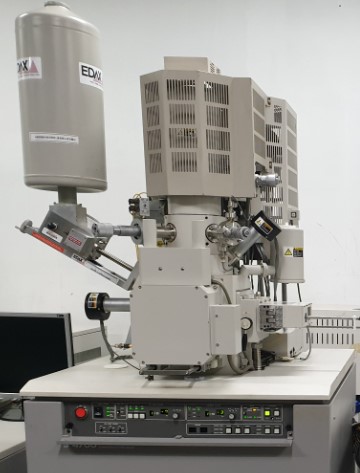
주사전자현미경(SEM)
SEM(Scanning Electron Microscope)
| 모델명/제조사 | S-4700 / Hitachi |
|---|---|
| 위 치 | 푸른솔문화관 111호 |
| 예약문의 | 02-961-0215 |
| 장비설명 |
- 주사전자현미경은 전자선이 시료면 위를 주사(scanning)할 때 시료에서 발생되는 여러 가지 신호 중 그 발생 확률이 가장 많은 이차전자(secondary electron) 또는 반사전자(back scattered electron)를 검출하는 것으로 대상 시료를 관찰한다. - Field emission scansmission electron microscopy (FE-SEM): 얇은 두께의 재료 및 생물 시료 표면 구조의 초미세 관찰 - Energy dispersive X-ray spectroscopy (EDS): 에너지분산형 분광분석법에 의한 미세 영역에서의 원소 함유량 및 분포 분석 - 분해능 1.5nm ( at 15Kv) l2.1nm ( at 1 kV) - 가속전압 : 0.5 ~ 30 kV- 배율 : 20 ~ × 500,000 - 최대시료크기 : 150mm dia |
|---|---|
| 용 도 |
- Cold Emmission Electron Source
- 다양한 Operation mode로 다양한 시료 관찰이 가능. - Two detector system 시료에 따라 사용자가 선택하거나 두 image를 섞을 수 있음. - SEM / EDX Integrated system SEM / EDX Image를 동시에 비교 분석할 수 있음. - 특수 대물렌즈 디자인으로 BSE 및 EDX 검출기를 동시에 부착할 수 있음. |
| 사용료 | 바로가기 |